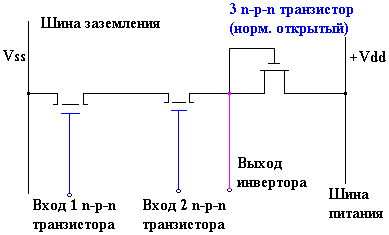
Транзистор на основе структуры металл - диэлектрик - полупроводник (МОП) является одним из наиболее широко используемых элементов СБИС. Первый транзистор, работающий на эффекте поля, был продемонстрирован в 1960 году. Сначала полевые транзисторы с двуокисью кремния в качестве подзатворного диэлектрика формировались на подложке n- типа проводимости. Затем из-за большей подвижности электронов, чем у дырок при формировании сверхбольших быстродействующих интегральных схем стали использовать n- канальные транзисторы, формируемые на p- подложке.
Рассмотрим основные технологические этапы производства n-МОП СБИС на примере создания логического вентиля И-НЕ с двумя входами.
Принципиальная схема вентиля (инвертора) приведена на рисунке.
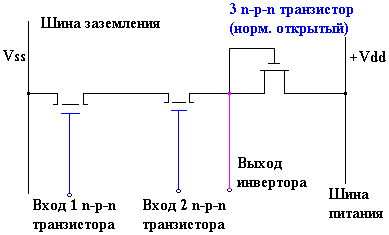
Схема состоит из последовательно соединенных двух транзисторов, работающих в режиме обогащения (нормально закрытых) и одного транзистора, работающего в режиме обеднения (нормально открытый). Все транзисторы располагаются между шиной источника питания Vdd и заземляющей шиной Vss. Затворы первых двух транзисторов служат входами схемы, а затвор третьего транзистора, соединенный с истоком второго, является выходом инвертора.
Нормально открытый транзистор служит источником тока для двух остальных. Выходное напряжение имеет низкое значение (логический нуль) только в том случае, когда оба первых транзистора открыты, т.е. на их затворы подан высокий потенциал - логическая единица.
Подложка.
В качестве подложки выбирают кремний p- типа проводимости легированный бором КДБ (100) с концентрацией примеси
Ориентация кремниевой подложки (100) имеет преимущество по сравнению с (111), заключающееся с более высокой подвижности электронов, обусловленной низкой плотностью поверхностных состояний на границе кремний-диэлектрик.
Этапы технологического процесса.
1 этап.
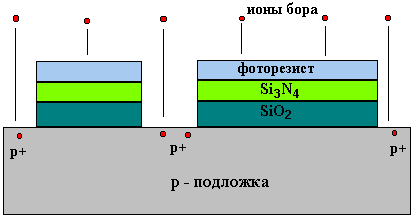
Ионная имплантация бора для создания изоляции между транзисторами с помощью p-n переходов.
На поверхность кремниевой подложки наносятся промежуточный слой термической двуокиси кремния и слой нитрида кремния, играющий роль маски при последующем локальном окислении кремния. Далее с помощью процесса литографии на поверхности вытравливаются окна, в которые осуществляется ионная имплантация бора. Иногда имплантацию осуществляют через слой окисла для уменьшения концентрации примеси в подложке и глубины ее проникновения.
2 этап.

На этом этапе проводятся следующие технологические операции:
- локальное окисление кремния (ЛОКОС процесс)
- формирование подзатворного окисла (после удаления промежуточных слоев двуокиси и нитрида кремния)
- имплантация бора для регулировки порогового напряжения нормально закрытых транзисторов
- формирование окна под скрытый контакт.
3 этап.

На данном этапе проводится ионная имплантация мышьяка для формирования канала нормально открытого транзистора. Использование мышьяка вместо фосфора обусловлено меньшей его глубиной в полупроводниковую подложку.
4 этап.

Проводится нанесение поликристаллического кремния с его последующим легированием мышьяком. Поликремний выполняет роль будущих затворов, предотвращает p- каналы от дальнейшей перекомпенсации акцепторной примеси мышьяком и служит материалом для последующего соединения стока и затвора нормально открытого транзистора. На этом этапе достигается самосовмещение стоков, истоков и затворов.
5 этап.
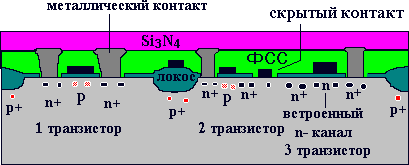
Заключительный этап формирования схемы. На нем осуществляются:
- литография под металлизацию к стокам и истокам транзисторов
- нанесение фосфорсиликатного стекла (ФСС). ФСС предотвращает диффузию ионов натрия, сглаживает рельеф поверхности, производит дополнительную активацию примеси.
- формируется пассивирующий диэлектрический слой (окисел или плазмохимический нитрид кремния).